-
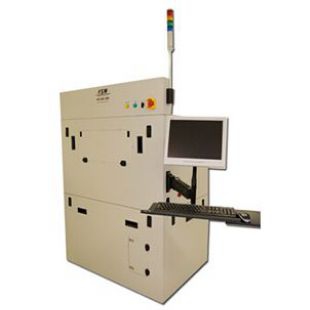
-
美國Frontier Semiconductor 晶圓厚度測量系統(tǒng)FSM 413 EC
- 品牌:美國Frontier Semiconductor
- 型號: FSM 413 EC
- 產(chǎn)地:美洲 美國
- 供應(yīng)商報價:面議
-
鉑悅儀器(上海)有限公司
 更新時間:2021-03-09 10:29:41
更新時間:2021-03-09 10:29:41 -
銷售范圍售全國
入駐年限第6年
營業(yè)執(zhí)照已審核
- 同類產(chǎn)品薄膜應(yīng)力測量儀(8件)

立即掃碼咨詢
聯(lián)系方式:400-822-6768
聯(lián)系我們時請說明在儀器網(wǎng)(www.ghhbs.com.cn)上看到的!
掃 碼 分 享 -
為您推薦
產(chǎn)品特點
- 非接觸式厚度測量,可以測量背面研磨減薄和刻蝕后的晶圓,也可測量粘附在藍膜或者其他載體上的有圖形或凸起的晶圓,可應(yīng)用于堆疊芯片和微機電系統(tǒng)。
詳細介紹
產(chǎn)品介紹:
非接觸式厚度測量,可以測量背面研磨減薄和刻蝕后的晶圓,也可測量粘附在藍膜或者其他載體上的有圖形或凸起的晶圓,可應(yīng)用于堆疊芯片和微機電系統(tǒng)。
優(yōu)勢:
FSM413回波探頭傳感器使用具有的紅外(IR)干涉測量技術(shù),可以直接和測量從厚到薄的晶圓襯底厚度變化和總體厚度變化。配置單探頭系統(tǒng),可以測量一些對紅外線透明的材料,例如Si, GaAs, InP, SiC, 玻璃,石英和一些聚合物,還可以測量常規(guī)有圖形、有膠帶、凸起或者鍵合在載體上晶圓的襯底厚度。配置雙探頭系統(tǒng)時,還提供晶圓整體厚度測量(包括襯底厚度和在光不能穿透的情況下的圖形高度厚度)。選配功能可以測量溝槽深度和通孔深度(包括微機電中的高深寬比的溝槽和通孔)。另外微機電應(yīng)用中薄膜厚度測量和凸塊高度測量也可以選配。基于FSM Echoprobe紅外線干涉測量技術(shù),提供非接觸式芯片厚度和深度測量方法。
Echoprobe技術(shù)利用紅外光束探測晶圓。
Echoprobe可用于測量多晶硅、藍寶石、其它復(fù)合物半導(dǎo)體,例如GaAs, InP, GaP, GaN 等。
對晶圓圖形襯底切割面進行直接測量。行業(yè)應(yīng)用:
主要應(yīng)用在研磨芯片厚度控制、芯片后段封裝、TSV(硅通孔技術(shù))、(MEMS)微機電系統(tǒng)、 側(cè)壁角度測量等。
針對LED行業(yè), 可用作檢測藍寶石或碳化硅片厚度及TTV其它應(yīng)用:
· 溝槽深度測量
· 表面粗糙度測量
· 薄膜厚度測量
· 環(huán)氧厚度測量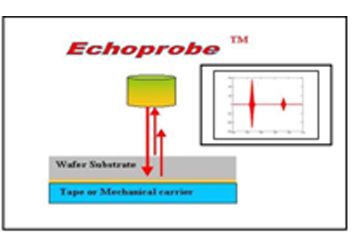
Echoprobe? 回波探頭技術(shù)可提供對薄晶圓(<100um)的襯底厚度或粘結(jié)結(jié)構(gòu)上的薄襯底進行直接和測量。
您可能感興趣的產(chǎn)品
-
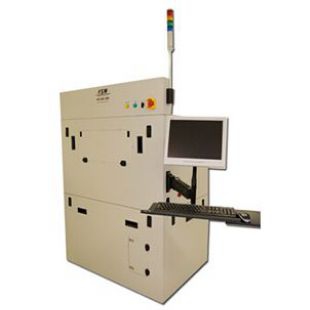 美國Frontier Semiconductor 晶圓厚度測量系統(tǒng)FSM 413 EC
美國Frontier Semiconductor 晶圓厚度測量系統(tǒng)FSM 413 EC
-
 晶圓厚度測量系統(tǒng) FSM - FSM 413
晶圓厚度測量系統(tǒng) FSM - FSM 413
-
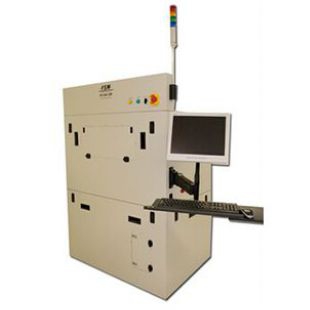 德國布魯克 晶圓厚度測量系統(tǒng)FSM 413 EC
德國布魯克 晶圓厚度測量系統(tǒng)FSM 413 EC
-
 美國Frontier Semiconductor 紅外干涉測量設(shè)備FSM 413
美國Frontier Semiconductor 紅外干涉測量設(shè)備FSM 413
-
 FR-Ultra晶圓厚度測量系統(tǒng)
FR-Ultra晶圓厚度測量系統(tǒng)
-
 美國Frontier Semiconductor 薄膜應(yīng)力及基底翹曲測試設(shè)備FSM 128
美國Frontier Semiconductor 薄膜應(yīng)力及基底翹曲測試設(shè)備FSM 128
-
 美國Frontier Semiconductor 薄膜應(yīng)力及基底翹曲測試設(shè)備FSM 500TC
美國Frontier Semiconductor 薄膜應(yīng)力及基底翹曲測試設(shè)備FSM 500TC
-
 FR-Ultra NIR N3 晶圓厚度測量系統(tǒng)
FR-Ultra NIR N3 晶圓厚度測量系統(tǒng)
-
 美國Frontier Semiconductor Line Card
美國Frontier Semiconductor Line Card
-
 紅外干涉測量設(shè)備FSM 413
紅外干涉測量設(shè)備FSM 413
-
 美國Frontier Semiconductor 全自動紫外線芯片應(yīng)力測量儀FSM360
美國Frontier Semiconductor 全自動紫外線芯片應(yīng)力測量儀FSM360
-
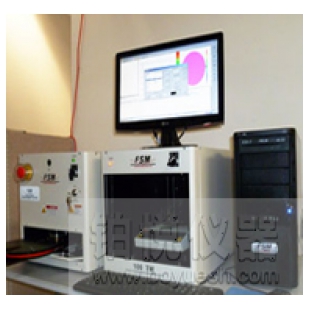 美國Frontier Semiconductor 薄膜應(yīng)力和硅片翹曲檢測儀
美國Frontier Semiconductor 薄膜應(yīng)力和硅片翹曲檢測儀
-
廠商推薦產(chǎn)品











